
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Reguliere onthechtingsmethoden
Met de vooruitgang van de verwerking van halfgeleiders en de stijgende vraag naar elektronische componenten is de toepassing van ultradunne wafers (dikte minder dan 100 micrometer) steeds belangrijker geworden. Door de voortdurende vermindering van de wafeldikte zijn wafels echter zeer kwetsbaar voor breuk tijdens daaropvolgende processen, zoals slijpen, etsen en metalliseren.
Tijdelijke bonding- en debonding-technologieën worden doorgaans toegepast om de stabiele prestaties en productieopbrengst van halfgeleiderapparaten te garanderen. De ultradunne wafel wordt tijdelijk op een stevig dragersubstraat bevestigd en na verwerking aan de achterkant worden de twee gescheiden. Dit scheidingsproces staat bekend als onthechting, en omvat voornamelijk thermische onthechting, laseronthechting, chemische onthechting en mechanische onthechting.
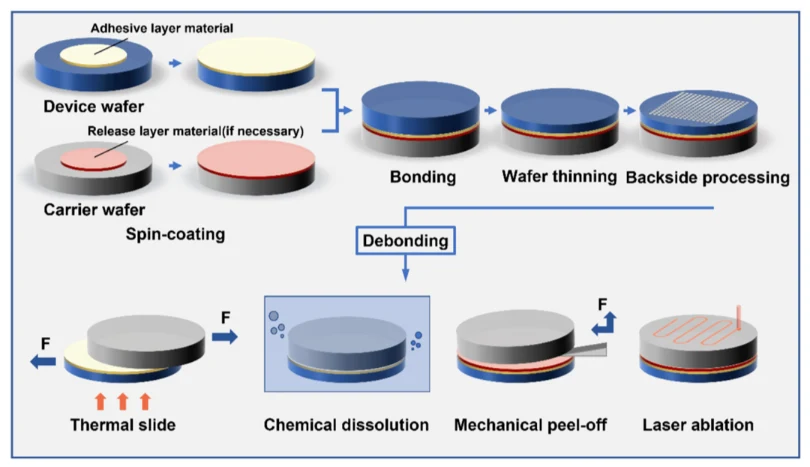
Thermische onthechting
Thermisch onthechten is een methode waarbij ultradunne wafers door verhitting worden gescheiden van dragersubstraten, waardoor de hechtkleefstof zachter wordt en ontleedt, waardoor de kleefkracht ervan verloren gaat. Het is hoofdzakelijk verdeeld in thermische dia-onthechting en thermische ontbinding.
Bij het thermisch verwijderen van de hechtingen door middel van glijbanen worden gewoonlijk de gebonden wafers verwarmd tot hun verwekingstemperatuur, die ongeveer varieert van 190°C tot 220°C. Bij deze temperatuur verliest de lijm zijn kleefkracht en kunnen ultradunne wafers langzaam van dragersubstraten worden geduwd of afgepeld door de schuifkracht die wordt uitgeoefend door apparaten zoalsvacuüm klauwplatenom een soepele scheiding te bereiken. Tijdens het ontbinden door thermische ontleding worden gebonden wafers verwarmd tot een hogere temperatuur, waardoor chemische ontleding (splitsing van de moleculaire keten) van de lijm ontstaat en de hechting volledig verloren gaat. Als gevolg hiervan kunnen gebonden wafers op natuurlijke wijze worden losgemaakt zonder enige mechanische kracht.
Laser-onthechting
Laser-onthechting is een onthechtingsmethode waarbij gebruik wordt gemaakt van laserstraling op de kleeflaag van gebonden wafers. De lijmlaag absorbeert de laserenergie en genereert warmte, waardoor een fotolytische reactie plaatsvindt. Deze aanpak maakt de scheiding mogelijk van ultradunne wafers van dragersubstraten bij kamertemperatuur of relatief lage temperaturen.
Een cruciale voorwaarde voor laserontbinding is echter dat het dragersubstraat transparant moet zijn voor de gebruikte lasergolflengte. Op deze manier kan de laserenergie met succes het dragersubstraat binnendringen en effectief worden geabsorbeerd door het hechtlaagmateriaal. Om deze reden is de selectie van de lasergolflengte van cruciaal belang. Typische golflengten omvatten 248 nm en 365 nm, die moeten worden aangepast aan de optische absorptie-eigenschappen van het hechtmateriaal.
Chemische onthechting
Bij chemisch onthechten worden scheidingen van gebonden wafers bereikt door de hechtende lijmlaag op te lossen met een speciaal chemisch oplosmiddel. Dit proces vereist dat oplosmiddelmoleculen de lijmlaag binnendringen om zwelling, ketensplitsing en uiteindelijk oplossen te veroorzaken, waardoor ultradunne wafers en dragersubstraten op natuurlijke wijze kunnen scheiden. Daarom is er geen extra verwarmingsapparatuur of mechanische kracht van vacuümklauwplaten vereist, terwijl chemische onthechting minimale spanning op de wafers genereert.
Bij deze methode worden dragerwafels vaak voorgeboord zodat het oplosmiddel volledig in contact kan komen met de hechtlaag en deze kan oplossen. De dikte van de lijm beïnvloedt de efficiëntie en uniformiteit van de penetratie en oplossing van het oplosmiddel. Oplosbare lijmen zijn meestal thermoplastische of gemodificeerde polyimide-gebaseerde materialen, meestal aangebracht door middel van spin-coating.
Mechanische onthechting
Bij mechanisch onthechten worden ultradunne wafers uitsluitend van de tijdelijke dragersubstraten gescheiden door gecontroleerde mechanische afpelkracht toe te passen, zonder hitte, chemische oplosmiddelen of lasers. Het proces is vergelijkbaar met het afpellen van tape, waarbij de wafer voorzichtig wordt "opgetild" door middel van nauwkeurige mechanische bediening.
Semicorex biedt hoogwaardige kwaliteitSIC poreuze keramische onthechtingsklauwplaten. Als u vragen heeft of aanvullende informatie nodig heeft, aarzel dan niet om contact met ons op te nemen.
Neem contact op met telefoonnummer +86-13567891907
E-mail: sales@semicorex.com




