
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe in chipproductie: een professioneel nieuwsrapport
De evolutie van halfgeleidermaterialen
Op het gebied van de moderne halfgeleidertechnologie heeft de meedogenloze drang naar miniaturisering de grenzen van traditionele op silicium gebaseerde materialen verlegd. Om aan de vraag naar hoge prestaties en een laag stroomverbruik te voldoen, is SiGe (Silicon Germanium) het favoriete composietmateriaal geworden bij de productie van halfgeleiderchips vanwege zijn unieke fysieke en elektrische eigenschappen. Dit artikel gaat dieper in op deepitaxie procesvan SiGe en zijn rol in epitaxiale groei, gespannen siliciumtoepassingen en Gate-All-Around (GAA) -structuren.
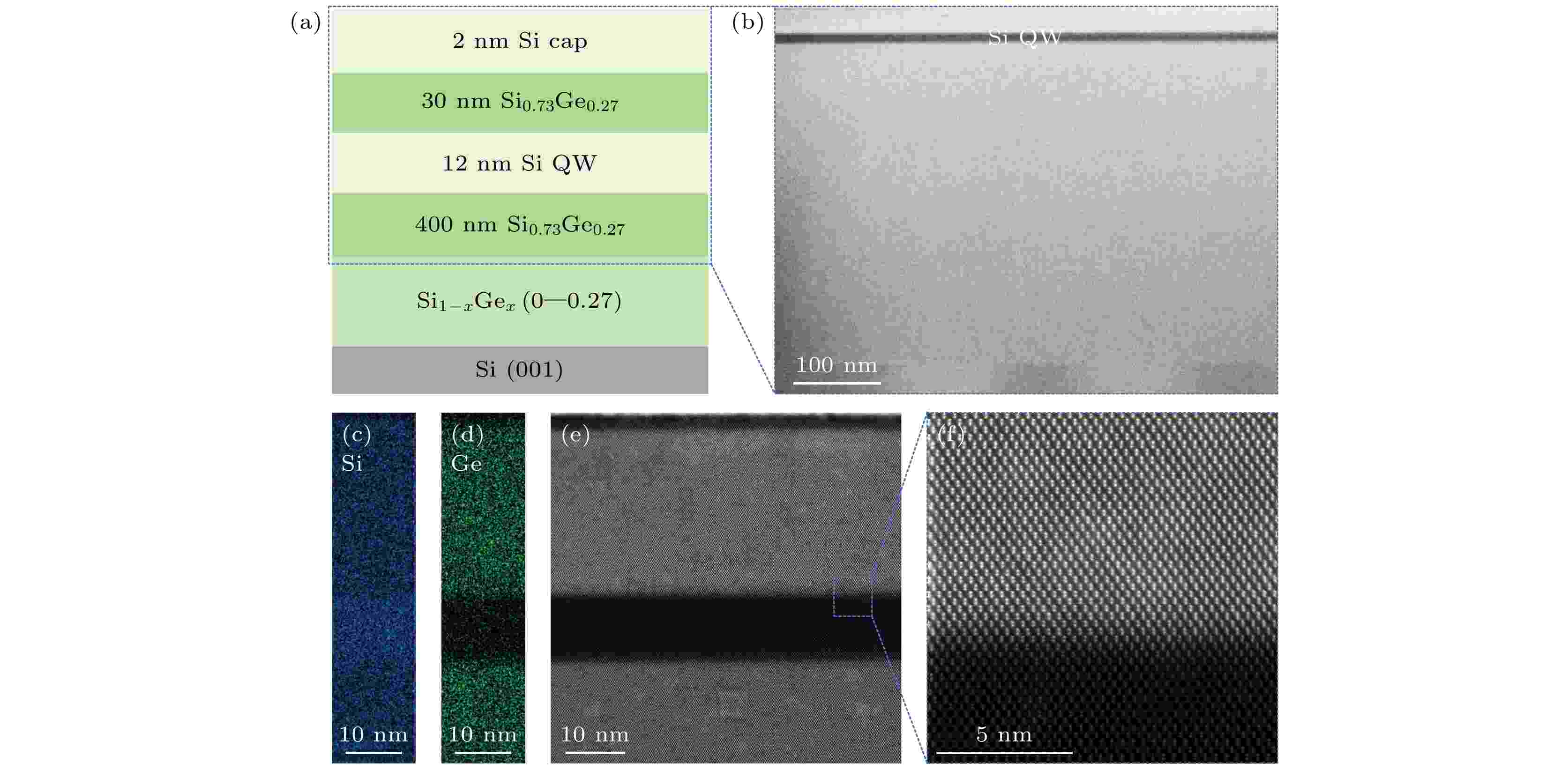
De betekenis van SiGe-epitaxie
1.1 Inleiding tot epitaxie bij de productie van chips:
Epitaxie, vaak afgekort als Epi, verwijst naar de groei van een monokristallijne laag op een monokristallijn substraat met dezelfde roosteropstelling. Deze laag kan beide zijnhomoepitaxiaal (zoals Si/Si)of heteroepitaxiaal (zoals SiGe/Si of SiC/Si). Er worden verschillende methoden gebruikt voor epitaxiale groei, waaronder Molecular Beam Epitaxy (MBE), Ultra-High Vacuum Chemical Vapour Deposition (UHV/CVD), Atmosferische en Reduced Pressure Epitaxy (ATM & RP Epi). Dit artikel richt zich op de epitaxieprocessen van silicium (Si) en silicium-germanium (SiGe), die veel worden gebruikt bij de productie van geïntegreerde schakelingen van halfgeleiders, met silicium als substraatmateriaal.
1.2 Voordelen van SiGe-epitaxie:
Het opnemen van een bepaald aandeel germanium (Ge) tijdens deepitaxie procesvormt een SiGe-monokristallaag die niet alleen de bandbreedte verkleint, maar ook de afsnijfrequentie (fT) van de transistor verhoogt. Dit maakt het uitgebreid toepasbaar in hoogfrequente apparaten voor draadloze en optische communicatie. Bovendien introduceert de roostermismatch (ongeveer 4%) tussen Ge en Si in geavanceerde CMOS-geïntegreerde circuitprocessen roosterspanning, waardoor de mobiliteit van elektronen of gaten wordt verbeterd en daarmee de verzadigingsstroom en reactiesnelheid van het apparaat worden vergroot.
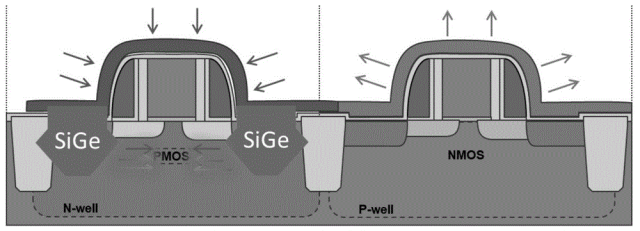
De uitgebreide SiGe-epitaxieprocesstroom
2.1 Voorbehandeling:
Siliciumwafels worden voorbehandeld op basis van de gewenste procesresultaten, waarbij voornamelijk de natuurlijke oxidelaag en onzuiverheden op het wafeloppervlak worden verwijderd. Voor zwaar gedoteerde substraatwafels is het van cruciaal belang om te overwegen of backsealing noodzakelijk is om auto-doping tijdens daaropvolgendeepitaxie groei.
2.2 Groeigassen en omstandigheden:
Siliciumgassen: Silaan (SiH₄), dichloorsilaan (DCS, SiH₂Cl₂) en trichloorsilaan (TCS, SiHCl₃) zijn de drie meest gebruikte bronnen van siliciumgas. SiH₄ is geschikt voor volledige epitaxieprocessen bij lage temperaturen, terwijl TCS, bekend om zijn snelle groeisnelheid, veel wordt gebruikt voor de bereiding van dikkesilicium epitaxielagen.
Germaniumgas: Germane (GeH₄) is de belangrijkste bron voor het toevoegen van germanium, dat in combinatie met siliciumbronnen wordt gebruikt om SiGe-legeringen te vormen.
Selectieve epitaxie: Selectieve groei wordt bereikt door de relatieve snelheden vanepitaxiale afzettingen in situ etsen met behulp van chloorhoudend siliciumgas DCS. De selectiviteit is te wijten aan het feit dat de adsorptie van Cl-atomen op het siliciumoppervlak minder is dan die op oxiden of nitriden, waardoor epitaxiale groei wordt vergemakkelijkt. SiH₄, dat Cl-atomen mist en een lage activeringsenergie heeft, wordt over het algemeen alleen toegepast op volledige epitaxieprocessen bij lage temperatuur. Een andere veelgebruikte siliciumbron, TCS, heeft een lage dampdruk en is vloeibaar bij kamertemperatuur, waardoor H2-borrelen nodig is om het in de reactiekamer te brengen. Het is echter relatief goedkoop en wordt vanwege zijn snelle groeisnelheid (tot 5 μm/min) vaak gebruikt om dikkere siliciumepitaxielagen te laten groeien, die op grote schaal worden toegepast bij de productie van siliciumepitaxiewafels.
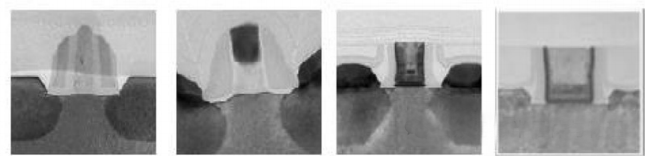
Gespannen silicium in epitaxiale lagen
Tijdensepitaxiale groeiwordt epitaxiaal Si-kristal met één kristal afgezet op een ontspannen SiGe-laag. Als gevolg van de roostermismatch tussen Si en SiGe wordt de Si-monokristallaag onderworpen aan trekspanning van de onderliggende SiGe-laag, waardoor de elektronenmobiliteit in NMOS-transistoren aanzienlijk wordt verbeterd. Deze technologie verhoogt niet alleen de verzadigingsstroom (Idsat), maar verbetert ook de reactiesnelheid van het apparaat. Voor PMOS-apparaten worden SiGe-lagen na het etsen epitaxiaal gegroeid in de source- en draingebieden om drukspanning op het kanaal te introduceren, waardoor de gatenmobiliteit wordt verbeterd en de verzadigingsstroom toeneemt.
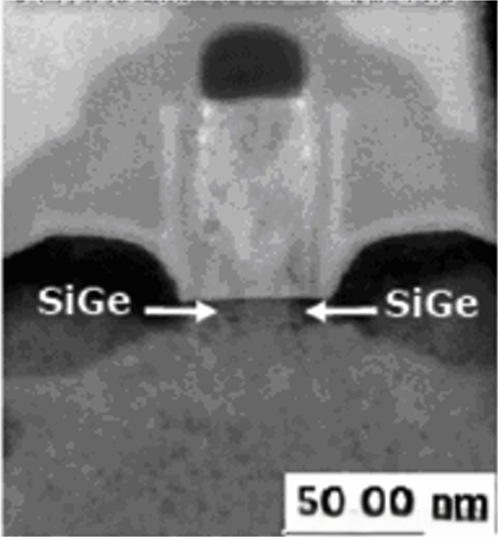
SiGe als opofferingslaag in GAA-structuren
Bij de productie van Gate-All-Around (GAA) nanodraadtransistoren fungeren SiGe-lagen als opofferingslagen. Anisotrope etstechnieken met hoge selectiviteit, zoals quasi-atomaire laagetsen (quasi-ALE), maken de precieze verwijdering van SiGe-lagen mogelijk om nanodraad- of nanosheet-structuren te vormen.
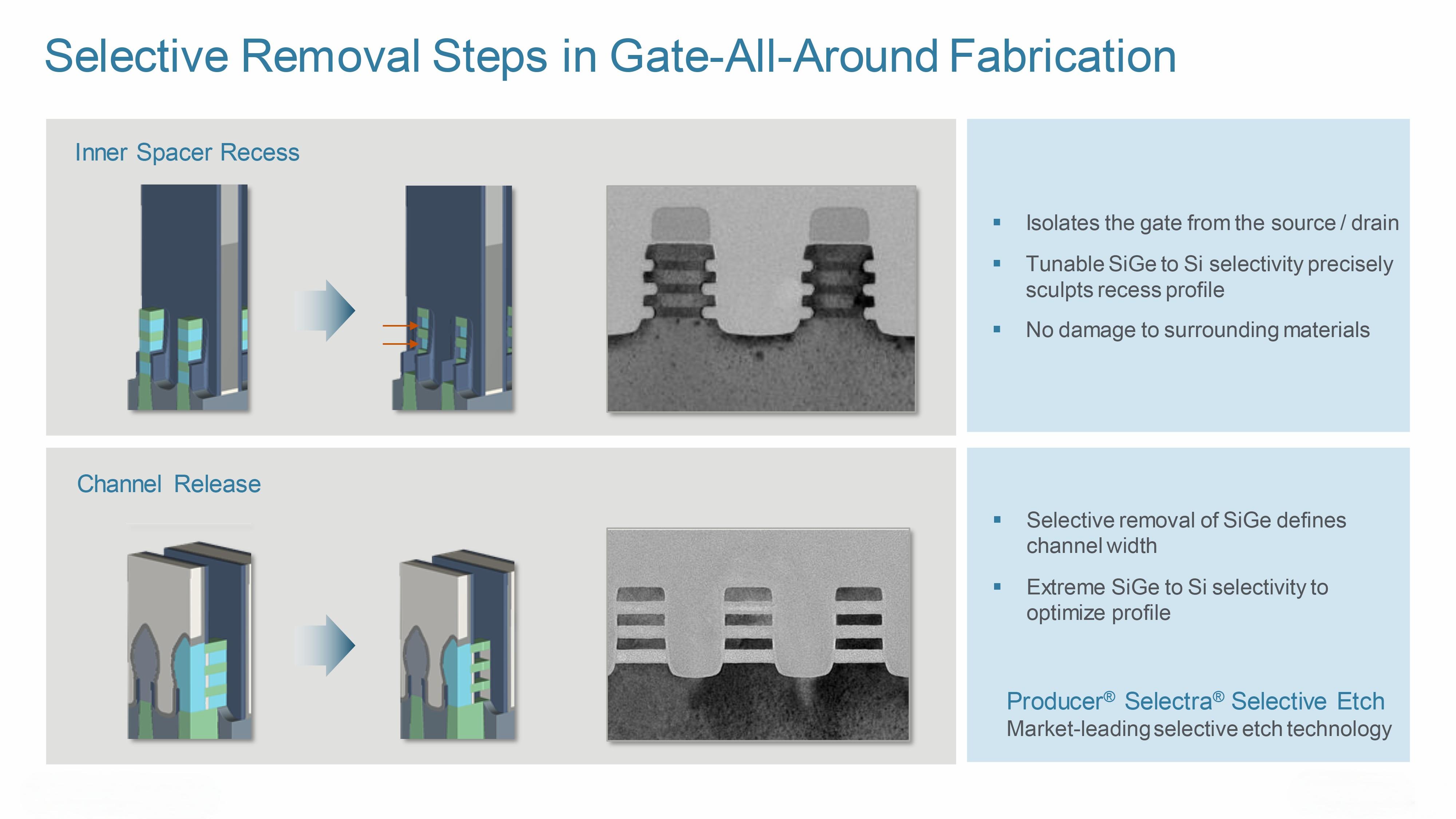
Wij van Semicorex zijn gespecialiseerd inSiC/TaC-gecoate grafietoplossingentoegepast in Si epitaxiale groei bij de productie van halfgeleiders. Als u vragen heeft of aanvullende informatie nodig heeft, aarzel dan niet om contact met ons op te nemen.
Contacttelefoon: +86-13567891907
E-mail: sales@semicorex.com




